MCL-HS200
ハロゲンフリー高Tg・低伝送損失・低熱膨張多層材料
製品基本情報
製品概要
- 製品形態
- CCL
- MCL-HS200
- プリプレグ
- GH-200
- 用途
- 半導体パッケージ(FC-CSP, PoP, SiP)
- 薄物モジュール基板
お問い合わせ
特長
- パッケージ材料と高周波材料の特徴を併せ持った材料です。
- X,Y方向の膨張係数が小さく(α1,α2)、ハロゲンフリーで優れた誘電特性を有します。(Dk 3.7, Df 0.0040@10 GHz)
- 低誘電ガラスクロスとの組合せによりDk3.4以下、Df0.0025以下を実現します。
- 高耐熱性を有しており、ビルドアップ構造に適しています。
一般特性
4層基板におけるそり評価結果
- TEG チップ
-
- チップサイズ:10 mm×10 mm
- チップ厚み:100 µm
- TEG 基板
-
- 基板サイズ:14 mm×14 mm
- L1, 4:12 µm
Cu:65 %, L2, 3:銅無し
ソルダレジスト:18 µm - コア材厚み:45 µm
- プリプレグ厚み:45 µm
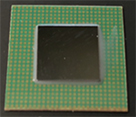

伝送損失評価結果
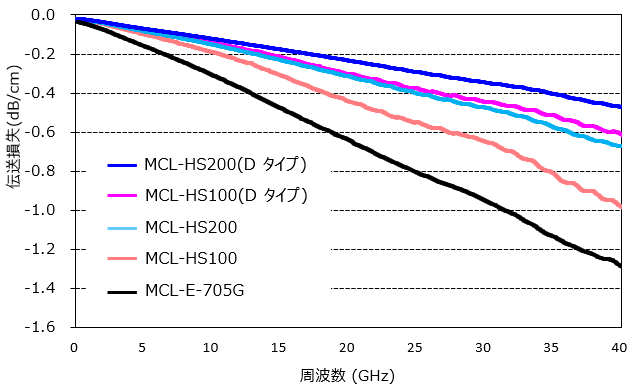
測定条件
- 評価基板:ストリップライン
- 温度及び湿度:25 ℃/60 %RH
- 特性インピーダンス:Approx.50 Ω
- 校正方法:TRL (Thru-Reflect-Line)
- 導体幅 (w):0.12~0.14 mm
- 絶縁層厚み (b):0.65 mm
- 導体厚み (t):18 µm
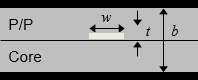
多層用銅張積層板
(t0.2, t0.4 mm)
- ※1 昇温速度:10 ℃/min
- ※2 空洞共振器法によります。
- ※3 「処理条件の読み方」
 参照
参照 - ※ 上記値は実測値であり、保証値ではありません。
一般仕様
多層用銅張積層板
- ※1 LP/HVLP:低プロファイル箔を示します。
- ※2 LP箔の銅箔厚さは3 µm、12 µmです。HVLPの銅箔厚さは12 µm、18 µmです。
- ※3 厚さは絶縁層の厚さを示します。
プリプレグ
- ※ 成形厚さは樹脂流れを0 %と仮定した場合のプリプレグ1枚当たりの厚さです。この値はプレス条件や内層パターンにより変わります。
お問い合わせ

