Epoxy Molding Compounds for Organic Substrates
CEL Series
About the product
Resonac’s epoxy molding compounds is suitable for semiconductor packages assembled with organic substrates such as BGA and CSP.
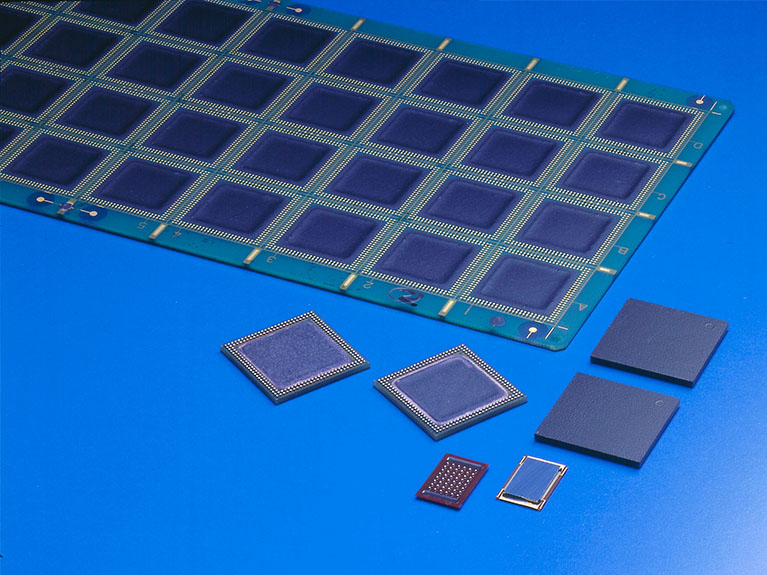
Inquiry of this product
Merits
- Control package warpage by controlling the elastic modulus and thermal expansion.
- Excellent reflow resistance with superior thermal resistance and adhesiveness.
- Applicable to transfer molding underfill (MUF).
- Applicable to low Dk/Df requirement for high frequency applications such as 5G.
- Excellent filling ability in small gaps as in SiP modules.
- Applicable to compression molding.
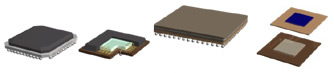
Applicable packages: CSP, BGA, Stacked MCP, etc.
Characteristics
Inquiry of this product

